AD学习笔记(26)——钻孔的组成元素
在 Altium Designer(AD)中,过孔(Via)是 PCB 设计中连接不同层的关键元素,其组成结构包含以下核心部分:

1. 物理结构组成
① 钻孔(Drill Hole)
- 定义:过孔的中心通孔,用于金属化填充。
- 参数:
- 孔径(Drill Size):通常为 8-20mil(0.2-0.5mm),需根据走线电流和工艺能力调整。
- 钻孔公差:默认 ±2mil(0.05mm),高精度设计需指定更严格公差。
② 铜镀层(Plated Layer)
- 定义:钻孔内壁沉积的铜层,实现层间电气连接。
- 参数:
- 铜厚:常规 18-35μm(0.5-1oz),高频或大电流场景需加厚(如 2oz)。
- 镀铜质量:需满足 IPC-2221 标准,确保镀层连续性和抗热冲击性。
③ 焊盘(Pad)
-
定义:覆盖在钻孔周围的铜环,提供焊接和电气连接区域。
-
参数:
- 外径(Pad Size):通常为孔径的 2 倍以上(如 12mil 孔径对应 24mil 焊盘)。
- 环形圈(Annular Ring):焊盘外径与孔径的差值,最小值 ≥4mil(IPC 标准)。
④ 阻焊层(Soldermask)
-
定义:覆盖焊盘的绿油层,防止焊接时桥连。(可以将其隐藏)
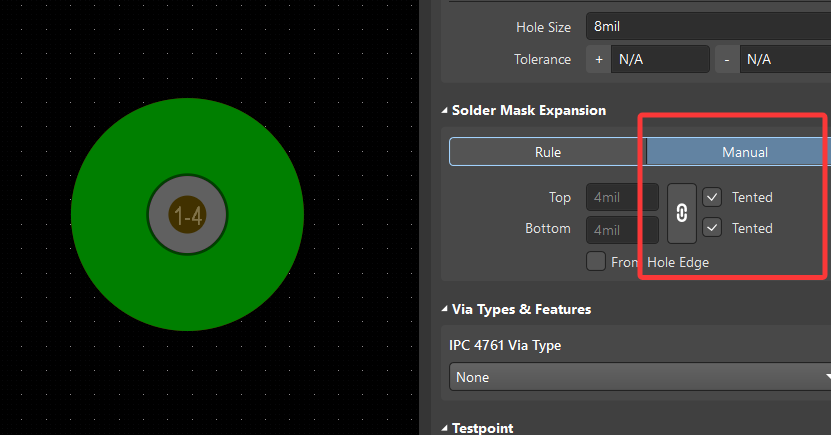
-
参数:
- 开窗(Solder Mask Expansion):默认比焊盘大 4-6mil,确保焊盘完全暴露。
⑤ 助焊层(Paste Mask)
- 定义:仅用于表面贴装过孔(如盘中孔设计),控制锡膏印刷区域。
- 参数:
- 尺寸:通常与焊盘一致或略小(0-2mil 收缩)。
2. 电气特性参数
① 寄生参数
- 寄生电容:过孔焊盘与相邻层之间的电容。(计算公式查)
- 寄生电感:影响高频信号,通常为 0.5-1nH,需通过减小过孔长度(如使用盲埋孔)优化。
② 阻抗控制
- 过孔阻抗:高频设计中需匹配走线阻抗(如 50Ω),通过减小焊盘直径、增加反焊盘(Thermal Relief)宽度实现。
3. AD 中的特殊过孔类型
① 盲孔(Blind Via)
- 结构:从表层连接到内层(如 Top→Layer2),需特殊工艺(如激光钻孔)。
- 参数:
- 最小孔径:4-6mil
- 焊盘直径:≥12mil
② 埋孔(Buried Via)
- 结构:仅在内层间连接(如 Layer2→Layer3),需多层压合工艺。
- 应用:高密度设计(如 BGA 扇出),减少表层过孔数量。
③ 微孔(Microvia)
- 结构:孔径 ≤6mil,用于 HDI 板(如手机 PCB)。
- 工艺:激光钻孔,可堆叠(Stacked)或错列(Staggered)排列。
4. 热焊盘与反焊盘
① 热焊盘(Thermal Pad)
- 定义:连接电源/地层时的十字形连接,减少焊接时散热过快。
- 参数:
- 桥宽:≥6mil
- 间隙:≥4mil
② 反焊盘(Anti-Pad)
- 定义:在电源/地层中与过孔焊盘隔离的区域,防止短路。
- 参数:
- 直径 = 焊盘直径 + 2×间隙(通常间隙为 10-15mil)。
过孔网路与周围网络一致时呈现十字连接的形状,不一致时呈现阻隔形状

- 直径 = 焊盘直径 + 2×间隙(通常间隙为 10-15mil)。
5. AD 中过孔的设置路径
在 AD 中创建或编辑过孔时,可通过以下路径配置参数:
- 放置过孔:快捷键
P→V,或从工具栏选择。 - 属性编辑:双击过孔,在弹出的
Via Properties对话框中设置:Designator:过孔编号(如 V1)。Location:坐标位置。Size and Shape:焊盘尺寸、孔径、形状(圆形/方形)。Layers:设置起始层和终止层。Net:分配网络(如 GND、VCC)。
6. 设计注意事项
- 电流容量:根据公式 (I = k \times T^0.44 \times A^0.725) 计算过孔载流量((k) 为常数,(T) 为温升,(A) 为铜截面积)。
- 高频信号:高速差分对过孔需成对添加,保持等长。
- 加工限制:
- 机械钻孔最小孔径:8mil(0.2mm)。
- 激光微孔最小孔径:4mil(0.1mm)。
- 盘中孔(Via-in-Pad):需添加阻焊塞孔工艺,防止焊锡流入过孔。
总结
AD 中的过孔设计需平衡电气性能、可制造性和成本,关键是根据信号类型(高速/低频)、电流大小和 PCB 层数选择合适的过孔类型及参数,并严格遵循所选 PCB 厂商的工艺规范。



 浙公网安备 33010602011771号
浙公网安备 33010602011771号