芯片化学机械抛光技术分析
芯片化学机械抛光技术分析
1)多层金属互连
2)电介质层的平面化
3)聚焦深度要求平面
4)实现高分辨率
5)粗糙的电介质表面也可能导致
6)金属化中的问题

平面化的定义
1)平面化是一个去除表面拓扑结构、使表面平滑和变平的过程
2)平整度表示表面的平整度和光滑度
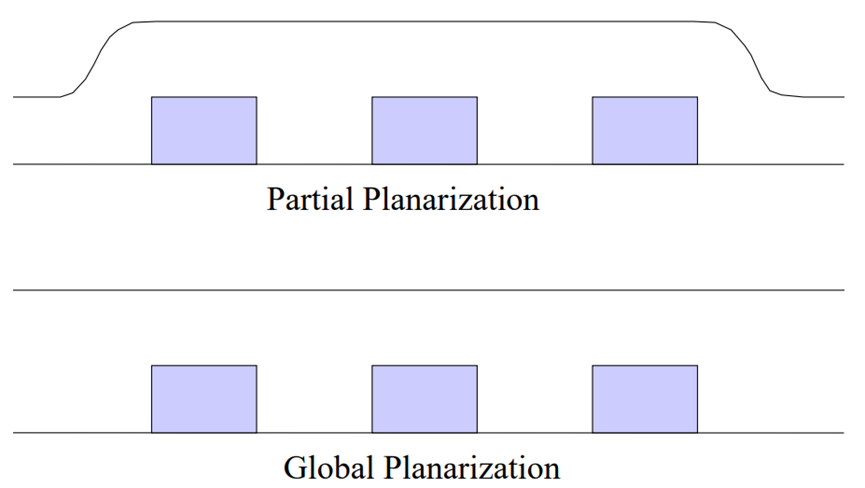
平面化
1)可以通过热流或回蚀来实现平滑和局部平坦化
2)小于0.35 mm的特征尺寸需要全局平坦化,这只能通过CMP实现
按沉淀
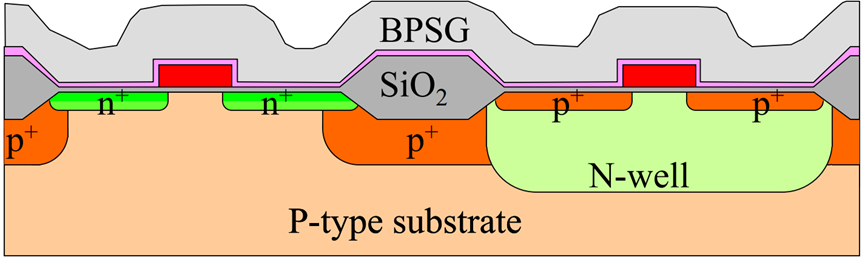
热流量之后

回蚀
1)氩溅射回蚀间隙角落处的电介质,并使开口变细
2)随后的CVD工艺很容易用合理的平面化表面填充间隙
3)具有CF4/O2化学的反应离子回蚀工艺进一步使表面平坦化
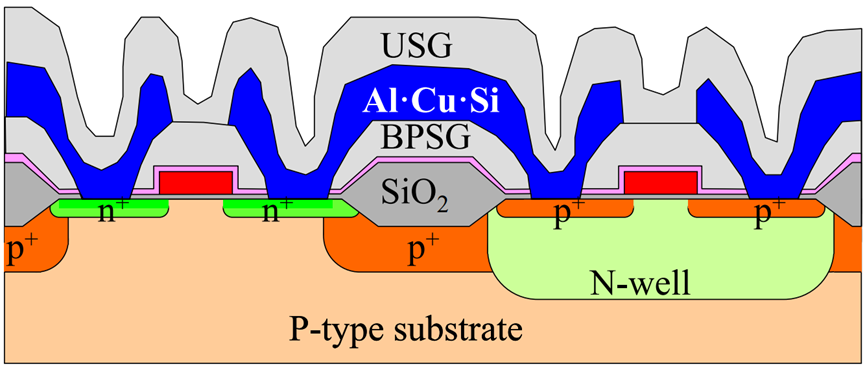
USG背面的溅射蚀刻
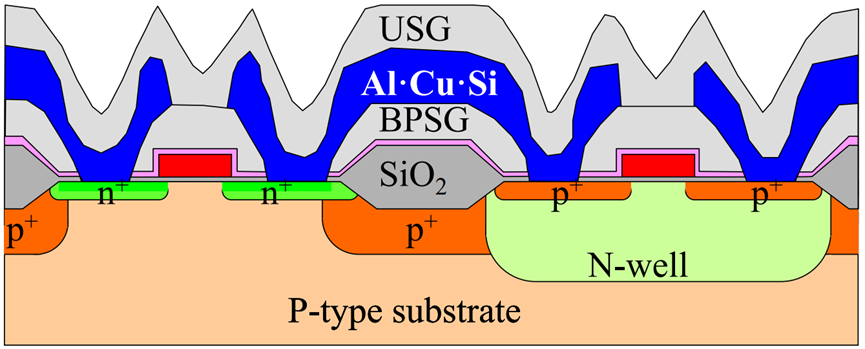
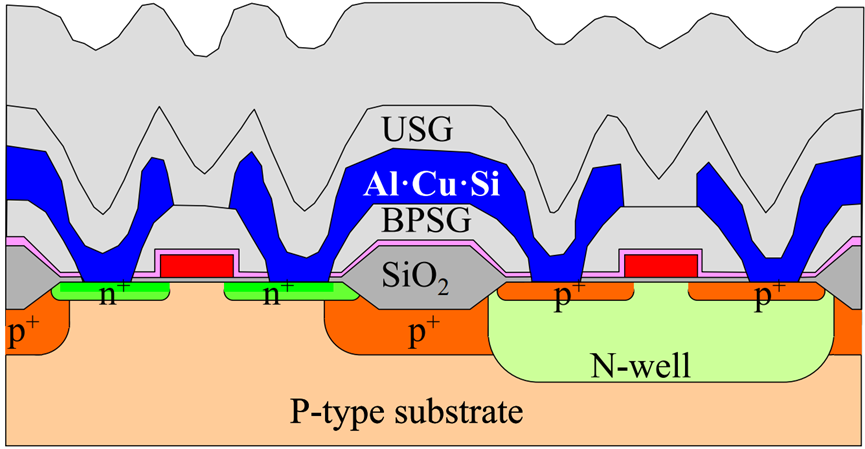
USG的反应蚀刻背面

介电台阶导致的金属线变薄
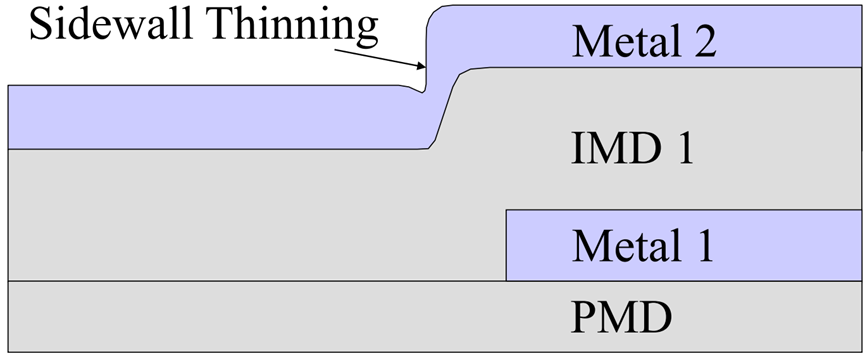
平面电介质表面,无金属线变薄效应
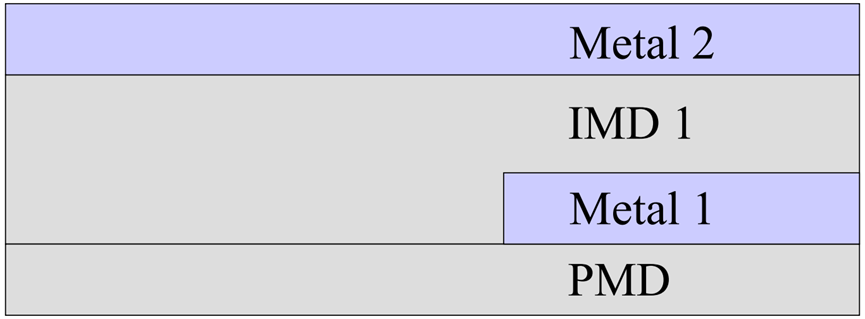
CMP的应用
1)STI形成
2)电介质层平面化
–PMD和IMD
1)钨塞形成
2)深沟电容器
CMP的应用

化学机械抛光
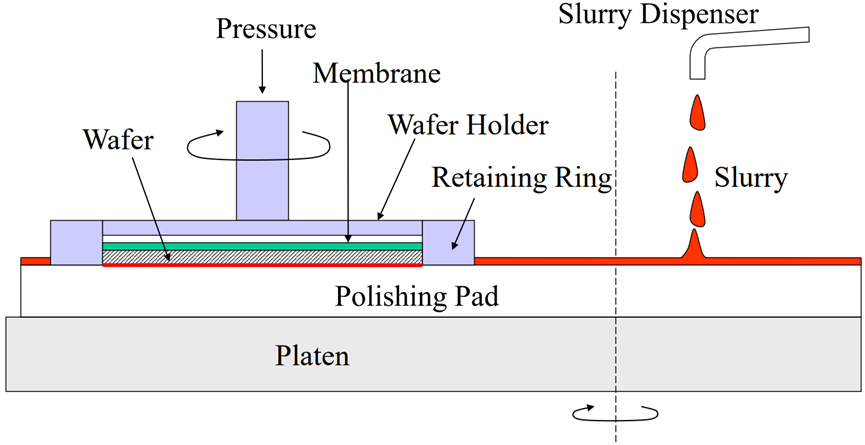
化学机械抛光线性抛光系统
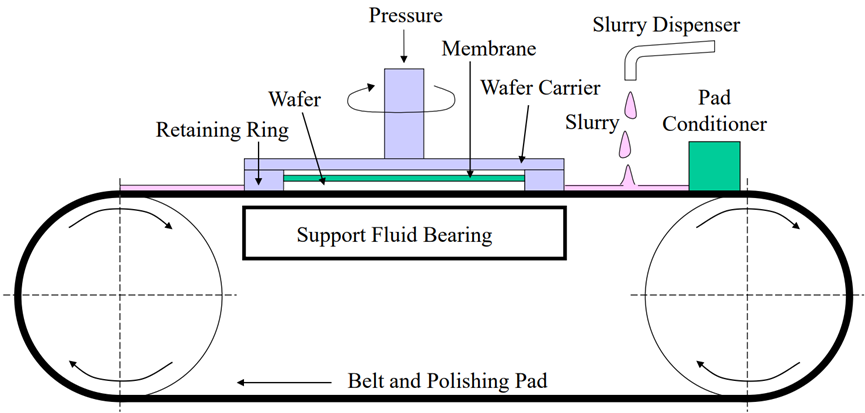
轨道抛光
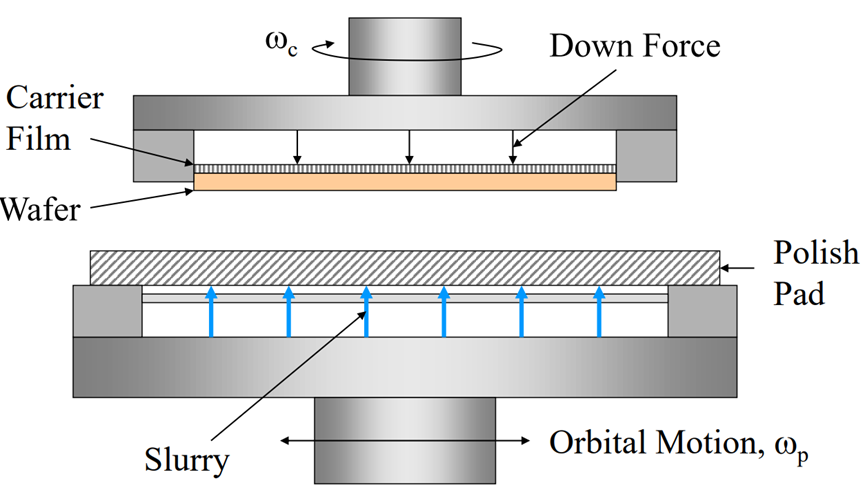
硬质粗糙垫
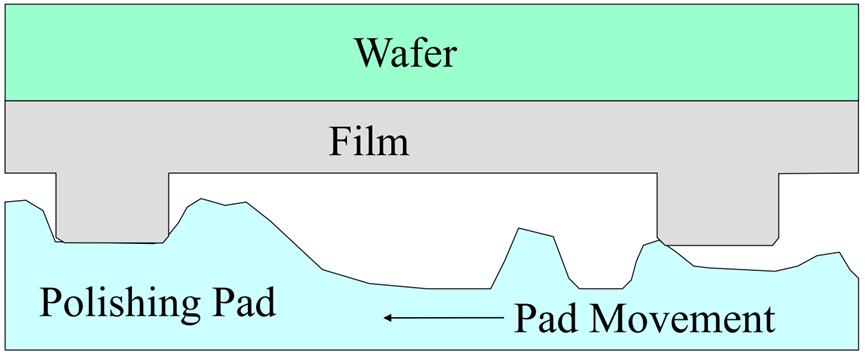
柔软光滑衬垫
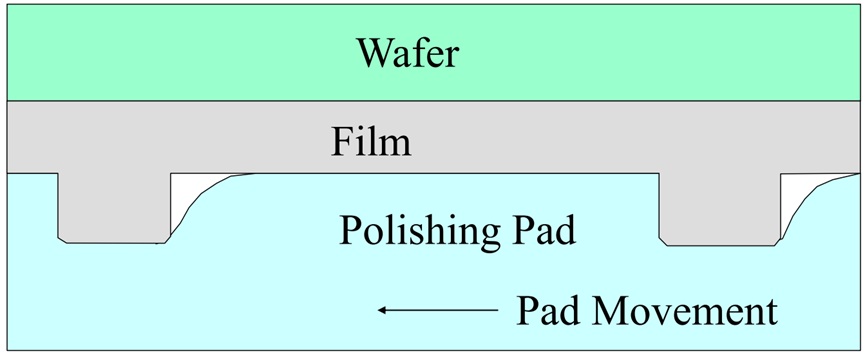
抛光头示意图
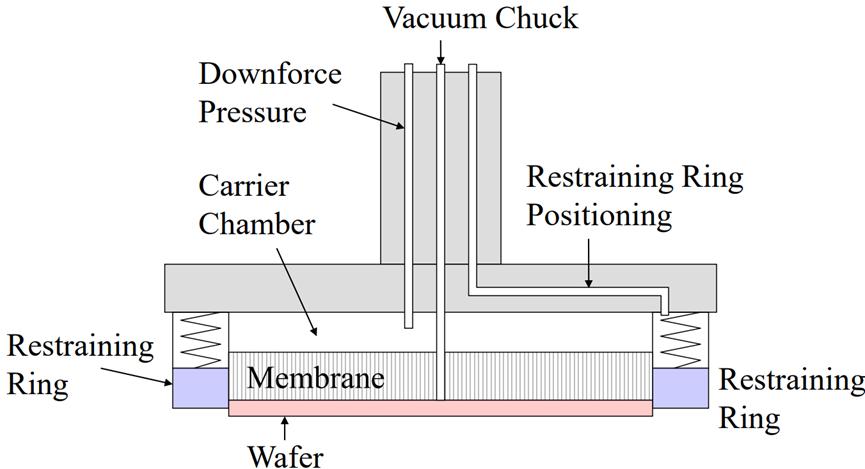
抛光垫和抛光垫调节剂

CMP调节剂的表面
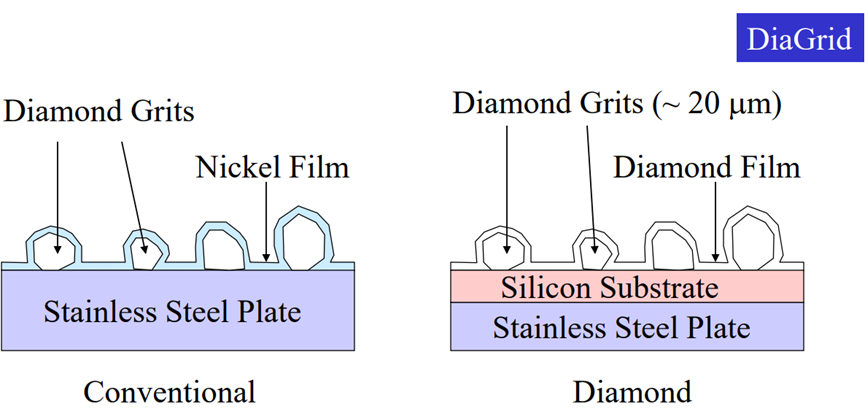
泥浆流
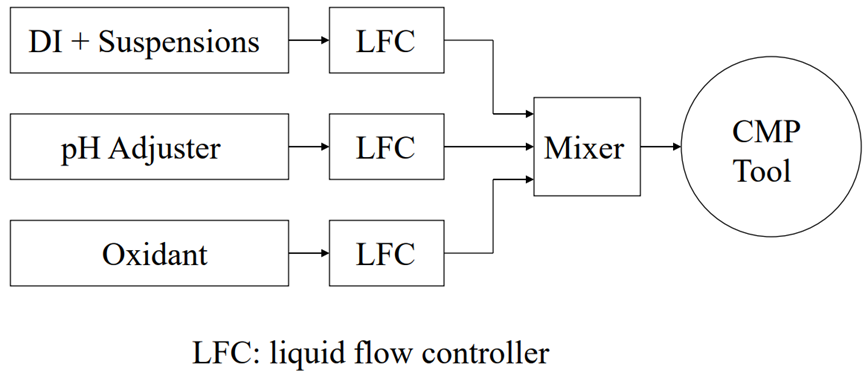
具有较高压力的突出零件

侵蚀导致电路开路
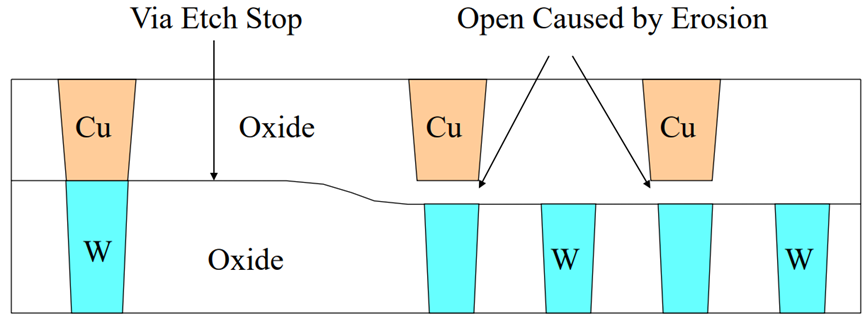
IC布局和侵蚀
1)IC设计布局会直接影响侵蚀问题

碟状效果

化学机械研磨

氧化物CMP,氢键

氧化物CMP,分子键

氧化物CMP,去除氧化物

金属CMP工艺
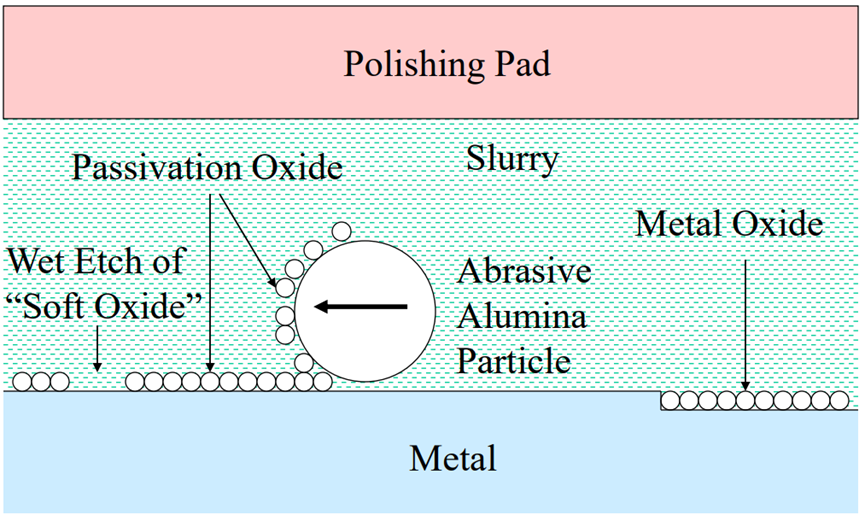
铜沉积
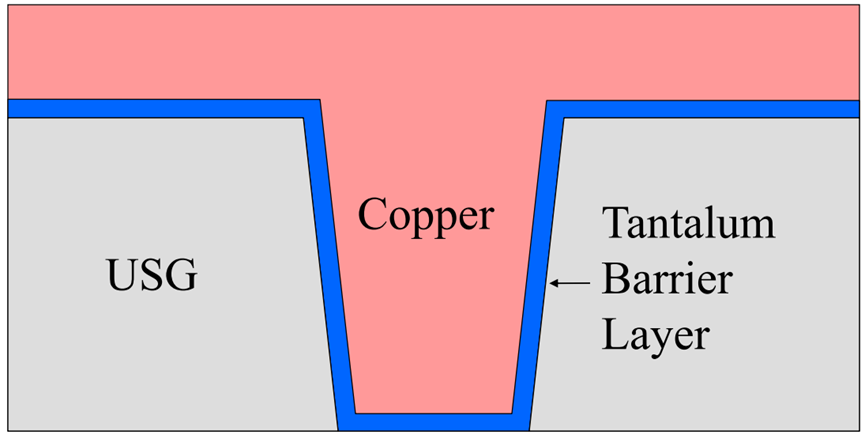
铜CMP
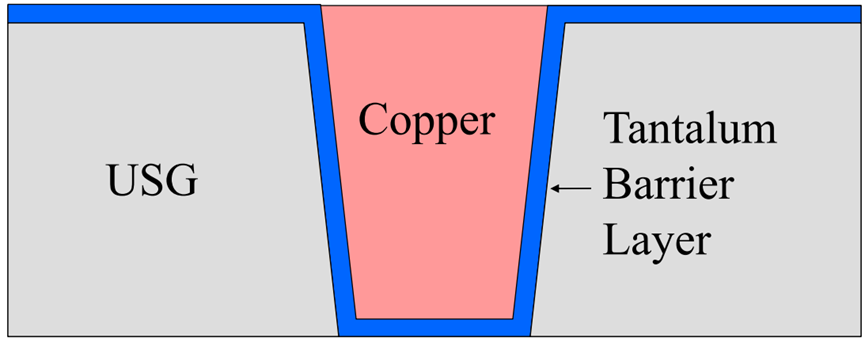
过度抛光以去除Tantalun

铜质碟形或凹陷

人工智能芯片与自动驾驶



 浙公网安备 33010602011771号
浙公网安备 33010602011771号